
11月21日下午,以“芯聚亿封·共创未来”为主题,“亿封智芯先进封装项目签约仪式”在深圳罗湖举行。该项目将由亿道信息、华封科技(Capcon)、深圳市罗湖区新创能科技产业投资合伙企业(有限合伙)(以下简称“罗湖新创能”)携手,共同投资建设一条先进封装产线。
根据工商资料显示,此次三方合资公司深圳市亿封智芯封装科技有限公司(简称“亿封智芯”),罗湖新创能是作为项目资金支持方,项目由亿道信息主导,华封科技提供先进封装设备与先进封装技术支持。
据介绍,亿封智芯先进封装产线将采用玻璃基板、2.5D和3D封装及全环保工艺等前沿技术,致力于满足国内芯片厂商、PCB板块厂商、终端客户的先进封装需求,推动机器人(具身智能)、AR/VR产品、AI眼镜、智能手表、便携式笔电、耳机等AI硬件与智能穿戴设备的创新,解决AI+终端及AI+应用在小型化、低功耗、长续航等方面的核心需求。
亿道信息董事长张治宇及华封科技董事长王宏波对芯智讯透露,“亿封智芯先进封装项目”一期计划投资5亿元,将由华封科技提供完整的先进封装产线交付以及先进封装技术支持,亿道信息主要负责产品的定义与设计以及客户的导入,该封装产线除了满足亿道信息自身的需求之外,也完全对外部具有先进封装需求的芯片客户、PCB板卡、终端设备厂商开放。预计,该先进封装产线最快将会在2026年底投产。
先进封装市场高速增长,但产能供应严重不足
随着摩尔定律越来越逼近物理极限,7nm以下先进制程的成本呈指数级增长,并且所能带来的性能的提升或能耗的降低却越来越有限。在此背景之下,芯片产业已从原有的单纯依赖制程工艺的升级来提升性能,转向了通过先进封装技术来实现异构集成、存算一体,破解功能墙、存储墙、面积墙与功耗墙所带来的瓶颈,从而提升整个集成电路系统级的性能,并实现更小尺寸、更高集成度和更低成本的目标。可以说,先进封装技术已经成为后摩尔时代发展的新路径。特别是随着近年来高性能计算(HPC)与人工智能(AI)芯片需求爆发,更是推动整个先进封装市场快速增长。
根据Yole Group的数据显示,2024年全球先进封装市场规模约为450亿美元,预计将以9.4%的年复合增长率持续增长,到2030年达到约800亿美元。其中,2.5D/3D先进封装的增长速度最快。比如,面向AI数据中心的基于2.5D/3D先进封装的处理器预计在2023年至2029年的年复合增长率将高达23%。未来先进封装将会成为整个封装市场的主流工艺。
对于中国国内市场来说,在美日荷三国联合对中国实施先进半导体制造设备出口限制之下,中国的先进制程发展严重受限,因此2.5D、3D先进封装也就成为了当前国内突破欧美封锁,实现系统级性能提升的重要手段。
有预测数据显示,2024年中国先进封装市场规模为698亿元人民币,预计到2029年将达到1705亿元人民币,年复合增长率高达19.6%。
从供应端来看,目前在先进封装市场,台积电的CoWoS先进封装技术占据主导地位,接下来就是半导体封测龙头日月光,三星、英特尔、安靠、长电科技等厂商也都在2.5D/3D封装技术上积极投入和扩产,但是头部厂商的先进封装产能供应仍是供不应求。

“2030年之前,台积电的所有的先进封装产能已经全部被客户包了。即使现在去找半导体封测龙头大厂日月光去要先进封装产能,也都要排到2028年以后,这还不包括明后年可能又有新出来的需求。即使他们的新的产能也在陆续开出,但依然是满足不了客户的需求。全球先进封装产能将面临长期供应短缺问题。”华封科技董事长王宏波在会上透露道。

△华封科技董事长王宏波
对于中国大陆本土的先进封装供应能力,王宏波则表示,受中美竞争的影响,中国大陆先进封测技术与海外仍存在着技术代差,有效产能依然有限,一些技术问题可能还在解决当中,并且可能还存在设备和材料上的依赖,这也导致中国大陆先进封装产能的瓶颈问题更为突出。

△亿道信息董事长张治宇
“满足国内旺盛的先进封装需求,是亿道信息和华封科技携手建先进封装产线的一个关键原因。”亿道信息董事长张治宇表示,“更为关键的是,先进封装技术除了主要被用于晶圆级的封装之外,也可以被应用到终端设备的核心模组上,推动终端设备的小型化、轻薄化、低功耗,在助力终端设备创新设计的同时,也能够进一步降低系统集成的成本,提升产品竞争力。”
从晶圆级封装到板级封装
据介绍,亿封智芯先进封装产线将采用2.5D和3D封装及全环保工艺等前沿技术,不仅可以满足众多高端芯片客户的晶圆级封装需求,也覆盖了板级先进封装客户的需求。
提及先进封装技术,很多人第一时间想到的应该就是台积电的CoWoS(Chip-on-Wafer-on-Substrate),这是一项被广泛应用于高端HPC、AI芯片的晶圆级先进封装的技术,这也使得外界认为先进封装主要是用于高端芯片,成本很高。
王宏波指出,这是外界对于先进封装技术认识的一个误区。实际上,随着先进封装技术的发展,比如面板级扇出型封装(FOPLP)、玻璃基板封装、CoPos(Chip-on-Panel-on-Substrate)等板级先进封装技术,不仅可以带来产能的提升,也更具有成本效益,可以为降低成本服务。不论是高端芯片,还是低端芯片,都能够利用板级先进封装技术来提升生产效率、降低成本。
目前板级先进封装工艺主要是面板级扇出型封装(FOPLP),其作为扇出晶圆级封装的延伸,将多个芯片、无源组件和互连集成在一个封装内,并以重新布线层(RDL)工艺,将芯片重新分布在具有面积利用率优势的方形基板上进行互连,相比传统封装工艺,不仅拥有产能优势,更具有成本效益。
此外,视为CoWoS的面板化解决方案CoPoS也具备上述优势,其作为2.5D封装的另外一种选择,其硅中介层替换成有机材料中介层、BT基板替换成玻璃基板,在各种互连架构中实现的再分配层,包括RDL interposer (CoWoS-R/ CoWoS-L)和玻璃芯基板上的RDL(玻璃版的FC-BGA)——这也是当前业界形成的共识,以应对下一代更高密度的AI芯片。
“板级先进封装成本甚至比传统封装还要便宜,成本甚至可以降低至传统封装的50%。”王宏波表示:“通过对于我们客户的调研发现,我们1台板级先进封装设备的产能可以替代传统的8台引线键合封装设备的产能。”

此外,传闻英伟达也在考察全新的 CoWoP(Chip-on-Wafer-on-Platform PCB)板级先进封装工艺,希望能够替代CoWoS。
根据现有的资料来看,CoWoP封装技术是先将裸芯片(Chip)通过微凸点倒装到硅中介层(Wafer)上完成芯片与硅基板的高密度互连,然后将整个芯片+硅基板组件用PCB的类载板(mSAP)制程直接焊接在PCB主机板上,省略掉CoWoS需要封装基板(如ABF/BT载板)的工序,PCB在此不仅承担电连接,还通过HDI或MSAP/SAP等工艺在板上形成精细的重分布层(RDL),保证信号完整性与功率分配。
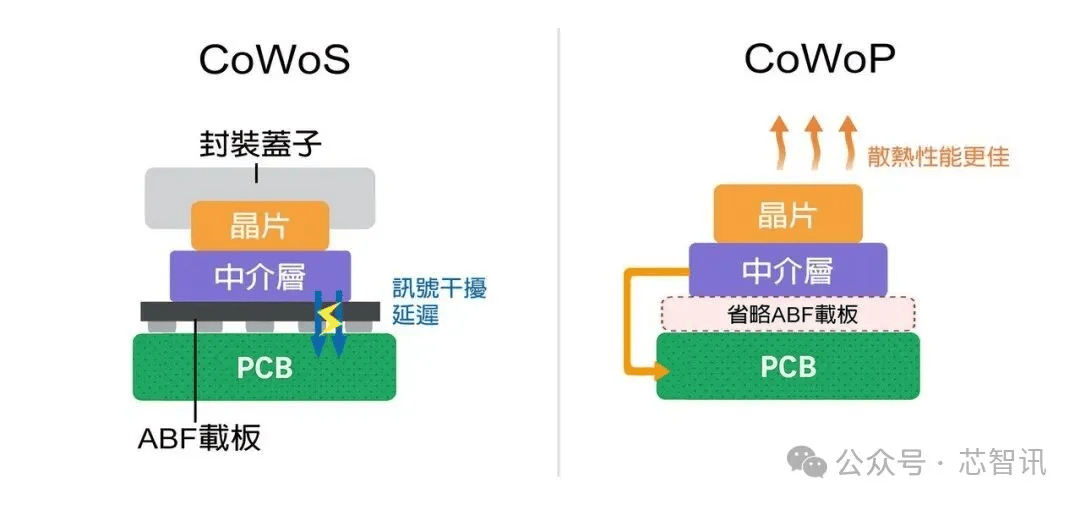
与CoWoS相比,CoWoP将封装基板与PCB一体化,实现更薄、更轻、更高带宽的模块设计,同时充分利用大尺寸PCB产线的高产能与成熟工艺,CoWoP用成熟大面板PCB替代昂贵的ABF/BT载板封装基板,不仅大幅降低材料与制造成本,还可加速PCB产线的高产能与短交付周期实现更快的量产,同时通过PCB上直接集成芯片、硅中介层和多层HDI/MSAP重分布层来减少封装层级,实现更薄更轻的板卡一体化设计,并在同一块板上完成多至10余层、30μm级线宽/线距的高速互连,兼具高带宽、低延迟与设计灵活性。
根据业界预计,CoWoP用大尺寸PCB面板替代了单价高昂的ABF基板(传统基板占封装成本40%以上),再加上无需BGA焊球、无盖子,整体可以使得成本降低30%-50%,并且利用成熟的PCB产线可以缩短交付周期。而且,PCB扩产周期仅需6-12个月,远低于传统基板的2年,可快速响应需求的爆发增长。
王宏波表示:“板级先进封装无论是在高端AI芯片,还是低端芯片,甚至是在模组方面,未来都将占据非常重要地位,需求将是极为巨大的。仅仅是用于替代传统的封装市场,就拥有千亿美元的市场规模。”
亿道信息为何跨界先进封装?
资料显示,亿道信息(股票代码001314.SZ)创立于2002年,是一家以 ODM 为模式,专业从事笔记本电脑、平板电脑、AI智能硬件、VR/AR/MR等电子设备的研发、设计、生产和销售的高新技术企业,为全球范围内的消费类电子产品以及行业三防类电子产品品牌商、系统集成商等客户提供定制化的产品方案设计、采购管理、生产制造等全流程服务。目前公司员工超过1600人,业务遍及100多个国家和地区,服务数千家行业客户。
那么,作为一家以主板设计为核心能力的ODM厂商,亿道信息为何会选择跨界来做先进封装呢?
对此,亿道信息董事长张治宇指出,在亿道信息二十多年长期的产品开发过程中,发现用户对硬件设备一直是围绕着几个核心的诉求:更强的性能,更轻薄小巧、更长的电池续航时间、更具成本优势。而随着先进封装工艺的发展,其已经成为助力终端设备解决上述痛点的重要推动力。
“这些核心需求在半导体上的要求更加的极致。特别是在后摩尔时代的AI热潮之下,众多的芯片厂商都希望通过晶圆级的先进封装技术来进一步提升芯片的集成度,以满足AI的高性能、低功耗需求。但是当前国内的先进封装产能严重不足,亿封智芯先进封装项目投建就是为了解决这一问题。同时,先进封装技术的很多方法和工艺也可以用在板级设计上。如果这些设计方法和先进封装工艺能够引入到板级系统设计和制造中,无疑将会对我们的终端产品的轻薄化、高性能、长续航带来进一步的突破,甚至有可能帮助我们实现代际的领先,这也是为什么我们选择进入到先进封装领域的另一个关键原因。”张治宇对芯智讯进一步解释道。
华封科技董事长王宏波也非常认同地表示:“原本要解决上述的用户痛点,需要在芯片设计、封装设计和系统级设计这三个关键环节进行分别的优化,但是随着先进封装技术的快速演进,未来会进行整合。即晶圆级先进封装设计+板级先进封装设计+系统的组装设计融合,把这些技术整合到一起之后,就能给客户交付更加小型化、轻薄化、长续航的终端产品。所以,我们认为,先进封装将会驱动整个行业重构,整个产业链重构。”
携手华封科技,强强联合
虽然亿道信息精准地看到了“先进封装”技术的旺盛需求和广阔市场前景,以及用于解决自身客户需求痛点的巨大潜力,但是其自身却并不具备先进封装技术能力和先进封装工厂的管理能力。这也是为什么亿道信息找来拥有整线解决方案的能力的知名半导体封测设备大厂华封科技进行深度合作的原因。
资料显示,华封科技成立于2014年,是聚焦先进封装设备领域的高端装备制造商。致力于为客户提供先进半导体封装的产品技术和解决方案。目前在新加坡、高雄、横琴、香港、北京、深圳、苏州等地设有分支机构。公司拥有先进封装设备领域全球技术领先的创始团队和产品技术,成熟的设备产品线已获得国际知名半导体封测厂商认可。服务的客户有台积电、日月光、矽品、长电科技、通富微电、DeeTee等知名封测大厂。
华封科技的产品对先进封装贴片工艺实现了全面覆盖,包括FOWLP(Face Up/Down)、POP、MCM、EMCP、Stack Die、SIP、2.5D/3D、FCCSP、FCBGA等。值得一提的是,华封科技还是日月光Fanout晶圆级工艺贴片机的全球唯一供应商。
“我们于先进封装的核心关键设备领域拥有完整的高端产品矩阵、设备部署落地经验和终端客户应用案例。与此同时,我们还拥有强大的先进封装工艺团队(由首席科学家杜嘉秦博士带队),我们能够为客户提供一流的、定制化的先进封装整体解决方案。”王宏波指出:“我们的整线解决方案就是要帮助PCB组装这个行业,用先进封装的技术提升他们的产品的竞争力,形成差异化的竞争优势。”
所谓整线解决方案,是华封科技2.0模式的核心,即为客户提供全套先进封装设备的同时,还提供先进封装技术的导入和先进封装工厂的运维服务,帮助客户实现系统级先进封装能力从无到有的突破。这一全新的商业模式也被华封科技视为未来的第二增长曲线。
王宏波表示:“我们通过这种非常复杂的行业资源的整合,帮助客户快速实现小型化、轻薄化、高性能、低功耗、低成本的模组产品以及终端产品,这就是我们的新模式。”

王宏波还以特斯拉的擎天柱机器人所使用的关节驱动器为例解释道,利用先进封装技术做的关节驱动器,只有一个硬币大小,异质集成了11颗芯片,可以实现1500W的高功率电驱。而使用传统封装技术的做的模组,体积是前者的数倍,但仅有250W的功率。显然,这个案例很好地展示了先进封装技术对于模组产品所带来的在性能和小型化方面的质的提升。
“华封科技与亿道信息合作的亿封智芯先进封装项目,是华封科技2.0战略的第一个落地案例。我们的整线解决方案将会深度赋能亿道信息,帮助亿道信息实现自有产品的小型化、轻薄化、长续航、低成本,提升亿道信息整个产品在行业内的竞争力。我们是用芯片级的技术去做终端产品,这就是降维打击。”王宏波非常有信心地说道。

张治宇也坦言:“华封科技在先进封装设备领域的技术及市场的领先地位,王宏波董事长对于先进封装行业趋势的精准判断和战略布局,杜博士领头的先进封装工艺团队的专业性和丰富的经验,这些都给了亿道信息足够的信心,所以我们才下定决心投身先进封装领域,希望在AI技术高速发展的当下,不仅能够为亿道信息自身产品创新需求服务,也能够为国内的半导体芯片厂商及其他ODM厂商提供先进封装服务,支持整个行业的创新。”
作者:芯智讯-浪客剑
 晋ICP备17002471号-6
晋ICP备17002471号-6